У сучаснай тэхналогіі электроннага дысплея, святлодыёдны дысплей шырока выкарыстоўваецца ў лічбавых шыльдах, этапе, упрыгожванні ў памяшканні і іншых палёў з -за высокай яркасці, высокай выразнасці, доўгага жыцця і іншых пераваг. У працэсе вытворчасці святлодыёднага дысплея тэхналогія інкапсуляцыі з'яўляецца ключавой спасылкай. Сярод іх тэхналогіі інкапсуляцыі SMD і тэхналогія інкапсуляцыі COB - гэта дзве асноўныя інкапсуляцыі. Такім чынам, у чым розніца паміж імі? Гэты артыкул дасць вам паглыблены аналіз.
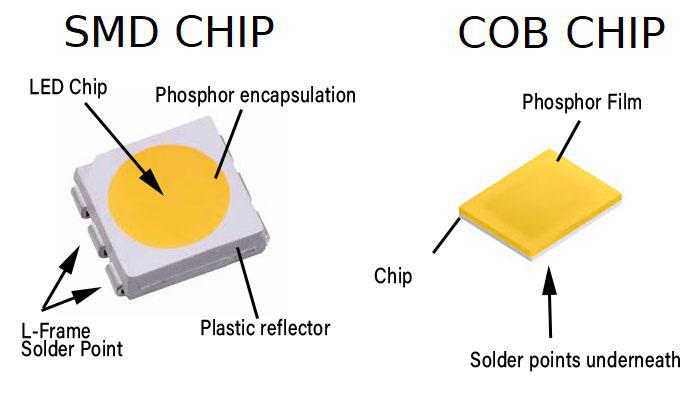
1. Што такое тэхналогія ўпакоўкі SMD, прынцып упакоўкі SMD
SMD -пакет, поўнае імя, усталяванае на паверхні (павярхоўнае прылада), з'яўляецца своеасаблівым электронным кампанентам, непасрэдна зварным да тэхналогіі павярхоўнай упакоўкі друкаванай платы (PCB). Гэтая тэхналогія праз машыну для размяшчэння дакладна Тэхналогія робіць электронныя кампаненты меншымі, лягчэйшымі ў вазе і спрыяе дызайну больш кампактных і лёгкіх электронных прадуктаў.
2. Перавагі і недахопы тэхналогіі ўпакоўкі SMD
2.1 Перавагі тэхналогіі ўпакоўкі SMD
(1)Невялікі памер, лёгкі вага:Кампаненты ўпакоўкі SMD маюць невялікія памеры, простыя ў інтэграцыі высокай шчыльнасці, спрыяючы дызайну мініяцюрызаваных і лёгкіх электронных прадуктаў.
(2)Добрыя высокачашчынныя характарыстыкі:Кароткія штыфты і кароткія шляхі злучэння дапамагаюць знізіць індуктыўнасць і супраціў, павысіць высокачашчынныя характарыстыкі.
(3)Зручна для аўтаматызаванай вытворчасці:Падыходзіць для аўтаматызаванага вытворчасці машыны для размяшчэння, павышэння эфектыўнасці вытворчасці і стабільнасці якасці.
(4)Добрая цеплавая прадукцыйнасць:непасрэдны кантакт з паверхняй друкаванай платы, які спрыяе рассейванню цяпла.
2.2 Недахопы тэхналогіі ўпакоўкі SMD
(1)Адносна складанае абслугоўванне: Хоць метад мацавання паверхні палягчае рамонт і замену кампанентаў, але ў выпадку інтэграцыі высокай шчыльнасці замена асобных кампанентаў можа быць больш грувасткай.
(2)Абмежаваная плошча рассейвання цеплааддачы:У асноўным пры рассейванні цяпла і геля, доўгая праца з высокай нагрузкай можа прывесці да канцэнтрацыі цяпла, што ўплывае на тэрмін службы.
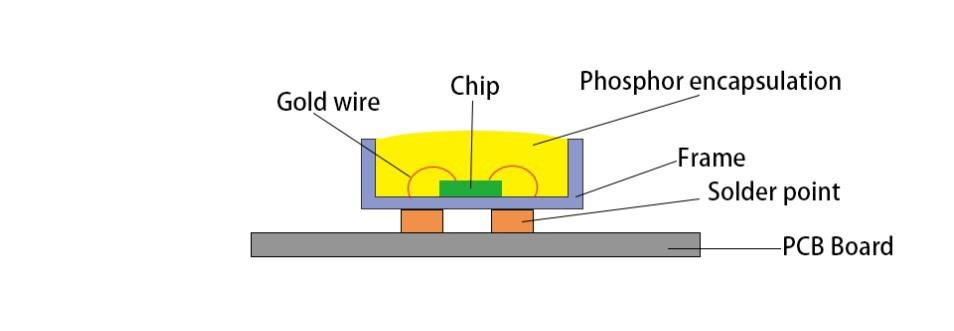
3. Што такое тэхналогія ўпакоўкі COB, прынцып упакоўкі COB
Пакет COB, вядомы як CHIP на борце (Chip на борце), з'яўляецца голым чыпам, непасрэдна зварным па тэхналогіі ўпакоўкі PCB. Канкрэтны працэс - гэта голы чып (чып -корпус і ўводу/выводу ў крышталі вышэй) з праводным або цеплавым клеем, звязаны з друкаванай платай, а затым праз дрот (напрыклад, алюміній або залаты провад) у ультрагукавым дзеянні, пад дзеяннем цеплавога ціску, клемы ўводу/вываду чыпа і накладкі друкаванай платы падключаюцца і, нарэшце, запячатаны абаронай ад смалы. Гэта інкапсуляцыя ліквідуе традыцыйныя этапы інкапсуляцыі святлодыёднай ліпені, што робіць пакет больш кампактным.
4. Перавагі і недахопы тэхналогіі ўпакоўкі COB
4.1 Перавагі тэхналогіі ўпакоўкі COB
(1) Кампактны пакет, невялікі памер:Ліквідуючы ніжнія штыфты, каб дасягнуць меншага памеру пакета.
(2) Вышэйшая прадукцыйнасць:Залаты провад, які злучае чып і плату, адлегласць перадачы сігналу кароткае, зніжаючы перакрыжаванне і індуктыўнасць і іншыя праблемы, каб павысіць прадукцыйнасць.
(3) Добрае рассейванне цяпла:Чып непасрэдна зварваецца да друкаванай платы, а цяпло рассейваецца праз усю дошку друкаванай платы, а цяпло лёгка рассейваецца.
(4) Моцная абарона:Цалкам закрытая канструкцыя, з воданепранікальнай, вільготнай, пылавой, антыстатычнай і іншымі ахоўнымі функцыямі.
(5) Добры візуальны вопыт:Як крыніца паверхні святла, прадукцыйнасць колеру больш яркая, больш выдатная апрацоўка дэталяў, прыдатная для доўгага прагляду.
4.2 Недахопы тэхналогіі ўпакоўкі COB
(1) Складанасці ў тэхнічным абслугоўванні:Прамая зварка чыпа і друкаванай платы, нельга разабраць асобна альбо замяніць чып, выдаткі на тэхнічнае абслугоўванне высокія.
(2) строгія патрабаванні да вытворчасці:Працэс упакоўкі экалагічных патрабаванняў надзвычай высокі, не дазваляе пылу, статычнай электраэнергіяй і іншымі фактарамі забруджвання.
5. Розніца паміж тэхналогіяй упакоўкі SMD і тэхналогіяй упакоўкі COB
Тэхналогія інкапсуляцыі SMD і тэхналогія інкапсуляцыі COB у галіне святлодыёднага дысплея мае свае унікальныя функцыі, розніца паміж імі ў асноўным адлюстроўваецца на інкапсуляцыі, памеры і вазе, прадукцыйнасці цяпла, прастаце абслугоўвання і сцэнарыяў прыкладання. Ніжэй прыведзены падрабязнае параўнанне і аналіз:
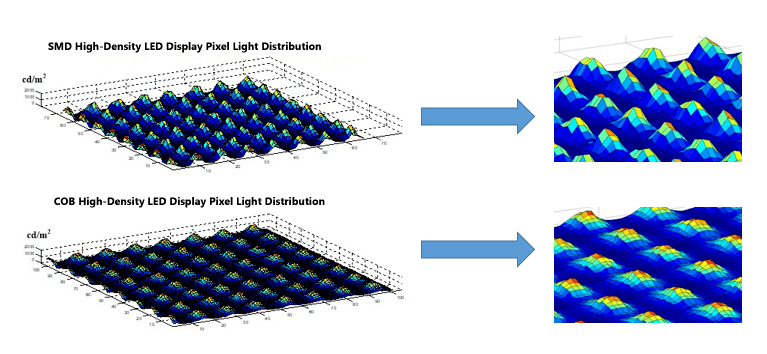
5.1 Метад упакоўкі
Technology Technology Technology: Поўнае імя - гэта павярхоўная прылада, якая ўяўляе сабой тэхналогію ўпакоўкі, якая прадаўцы ўпакаванага святлодыёднага чыпа на паверхні друкаванай платы (друкаванай друкаванай платы) праз машыну Precision Patch. Гэты метад патрабуе загадзя ўпакоўкі святлодыёднага чыпа, каб утварыць незалежны кампанент, а затым усталяваны на друкаванай плаце.
⑵COB Тэхналогія ўпакоўкі: Поўнае імя - CHIP на борце, гэта тэхналогія ўпакоўкі, якая непасрэдна прадае голы чып на друкаванай плаце. Гэта выключае крокі ўпакоўкі традыцыйных святлодыёдных шарыкаў, непасрэдна злучаецца голы чып з друкаванай платай з праводкай або цеплаправодным клеем і рэалізуе электрычную сувязь праз металічны дрот.
5.2 Памер і вага
⑴SMD ўпакоўка: Хоць кампаненты невялікія па памеры, іх памер і вага па -ранейшаму абмежаваныя з -за структуры ўпакоўкі і патрабаванняў PAD.
Пакет ⑵COB: З -за апушчэння ніжніх штыфтоў і абалонкі пакета, пакет COB дасягае больш экстрэмальнай кампактнасці, што робіць пакет меншым і лягчэйшым.
5.3 Прадукцыйнасць рассейвання цяпла
⑴SMD ўпакоўка: у асноўным рассейвае цяпло праз калодкі і коллоіды, а плошча рассейвання цяпла адносна абмежаваная. Пры высокай яркасці і ўмовах высокай нагрузкі цяпло можа быць сканцэнтравана ў зоне чыпа, што ўплывае на жыццё і стабільнасць дысплея.
⑵COB Пакет: чып непасрэдна зварваецца на друкаванай плаце, а цяпло можа быць рассеяна праз усю дошку друкаванай платы. Гэтая канструкцыя значна паляпшае прадукцыйнасць дысплея цеплавой рассейвання і зніжае хуткасць адмоваў з -за перагрэву.
5.4 Зручнасць тэхнічнага абслугоўвання
⑴SMD ўпакоўка: Паколькі кампаненты ўсталёўваюцца незалежна на друкаванай плаце, замяніць адзін кампанент падчас тэхнічнага абслугоўвання адносна лёгка. Гэта спрыяе зніжэнню выдаткаў на тэхнічнае абслугоўванне і скарачэння часу абслугоўвання.
⑵COB ўпакоўка: Паколькі чып і друкаваная друкаваная плата непасрэдна зварваюцца ў цэлае, немагчыма разбіраць альбо замяніць чып асобна. Пасля таго, як няспраўнасць узнікае, звычайна неабходна замяніць усю дошку друкаванай платы альбо вярнуць яе на завод на рамонт, што павялічвае кошт і складанасць рамонту.
5.5 Сцэнарыі прымянення
Packaging: З-за высокай сталасці і нізкіх выдаткаў на вытворчасць яна шырока выкарыстоўваецца на рынку, асабліва ў праектах, якія адчуваюць эканамічна і патрабуюць высокага зручнасці абслугоўвання, напрыклад, на адкрытых білбордах і сценах у памяшканні.
Упакоўка COB: З-за высокай прадукцыйнасці і высокай абароны яна больш падыходзіць для экранаў дысплея высокага класа ў памяшканні, публічных дысплеях, нумарах маніторынгу і іншых сцэн з высокімі патрабаваннямі да якасці і складанай асяроддзя. Напрыклад, у камандных цэнтрах, студыях, вялікіх дыспетчарскіх цэнтрах і іншых умовах, дзе супрацоўнікі доўга назіраюць за экранам, тэхналогія ўпакоўкі COB можа забяспечыць больш далікатны і раўнамерны візуальны вопыт.
Выснова
Тэхналогія ўпакоўкі SMD і тэхналогія ўпакоўкі COB маюць свае унікальныя перавагі і сцэнарыі прыкладанняў у галіне святлодыёдных экранаў. Карыстальнікі павінны ўзважваць і выбіраць у адпаведнасці з рэальнымі патрэбамі пры выбары.
Тэхналогія ўпакоўкі SMD і тэхналогія ўпакоўкі COB маюць свае перавагі. Тэхналогія ўпакоўкі SMD шырока выкарыстоўваецца на рынку з-за высокай сталасці і нізкіх выдаткаў на вытворчасць, асабліва ў праектах, якія адчуваюць эканамічна і патрабуюць высокага зручнасці тэхнічнага абслугоўвання. З іншага боку, тэхналогія ўпакоўкі COB мае моцную канкурэнтаздольнасць на экранах высокага класа ў памяшканні, публічных дысплеях, памяшканнях маніторынгу і іншых палёў з кампактнай упакоўкай, цудоўнай прадукцыйнасцю, добрай цеплавой рассейваннем і моцнай абаронай.
Час паведамлення: 10 верасня 2014 г.


